OSAT Cina baru menembus rantai pasokan pengemasan FO, seperti ECHINT (mantan ESWIN), Casmeit dan Sky Semikonduktor.
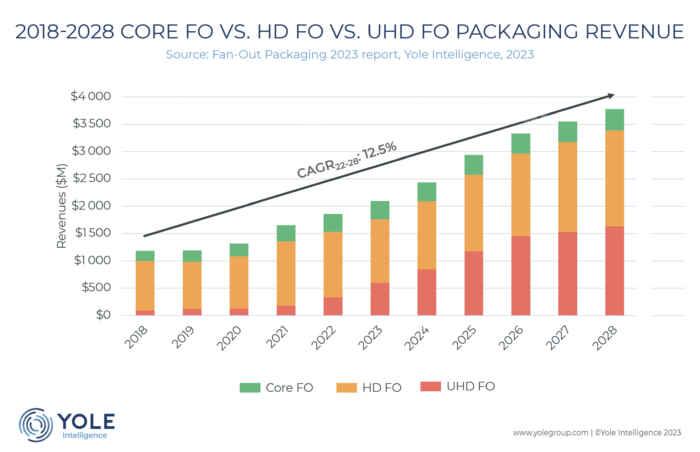
TSMC adalah pemain pengemasan FO terbesar, dengan pangsa pasar 76.7%.
Chiplet dan integrasi heterogen mendorong pengembangan kemasan FO.
Pendapatan pengemasan FO adalah $1.86 miliar pada tahun 2022. Yole mengharapkannya memiliki CAGR sebesar 12.5% hingga tahun 2028, mencapai $3.8 miliar.
UHD (Ultra-High Density) FO akan mengalami pertumbuhan tercepat di semua kelas pasar, dengan CAGR sebesar 30%, tumbuh dari $338 juta pada tahun 2022 menjadi $1,630 juta pada tahun 2028.
“HD (High Density) FO adalah kelas pasar yang mendominasi pada tahun 2022 dengan pendapatan $1,194 juta, dan akan memiliki CAGR 6.7%, mencapai $1,757 juta pada tahun 2028,” kata Gabriela Pereira dari Yole, “FO inti akan memiliki CAGR 2.8% , meningkat dari $329 juta pada tahun 2022 menjadi $389 juta pada tahun 2028.”
Volume FO WLP (Wafer-Level Packaging) masih akan mendominasi pasar, dengan produksi wafer sebesar 2,376K pada tahun 2028, dibandingkan dengan produksi setara wafer 238K 300 mm untuk FO PLP .
Total volume paket FO akan tumbuh dari 2,348 juta unit pada 2022 menjadi 2,960 pada 2028.
TSMC adalah pemain pengemasan FO terbesar, dengan pangsa pasar 76.7%.
Tiga perusahaan OSAT teratas, ASE, Amkor, dan JCET, bersama dengan TSMC, memiliki lebih dari 90% pasar fan-out pada tahun 2022.
Kemasan FO telah berevolusi dari kemasan low-end teknologi menjadi platform integrasi berkinerja tinggi, dengan adopsi yang semakin meningkat di pasar HPC, jaringan, otomotif, dan seluler kelas atas.
Salah satu tren pasar utama yang mendorong teknologi pengemasan fan-out adalah partisi cetakan besar menjadi chiplet dan integrasi heterogen.
Fan-out adalah platform hemat biaya yang memungkinkan interkoneksi die-to-die dengan bandwidth tinggi dan kepadatan tinggi melalui proses berbasis RDL.
UHD FO akan mengambil pangsa pasar dari Si Interposer di masa depan melalui jembatan FO-on-substrate dan FO-embedded yang inovatif
TSMC adalah pemimpin pasar dalam solusi FO berperforma tinggi untuk komputasi kelas atas, jaringan, dan aplikasi HPC.
ASE, SPIL, Samsung, JCET, Amkor, PTI, TFME, dan Nepes sedang mengembangkan solusi serupa dengan potensi besar untuk bersaing.
Meskipun core FO adalah pasar utama OSAT, perkembangan utamanya ada pada teknologi HD dan UHD FO.
FO PlP (Panel-Level Packaging) telah digembar-gemborkan sebagai solusi untuk adopsi FO secara luas, terutama untuk ukuran kemasan yang besar.
Namun, masih ada tantangan teknis, dan ada kekurangan permintaan untuk mencapai manfaat biaya yang diinginkan