OSAT Cina baharu sedang menembusi rantaian bekalan pembungkusan FO, seperti ECHINT (bekas ESWIN), Casmeit dan Sky Semikonduktor.
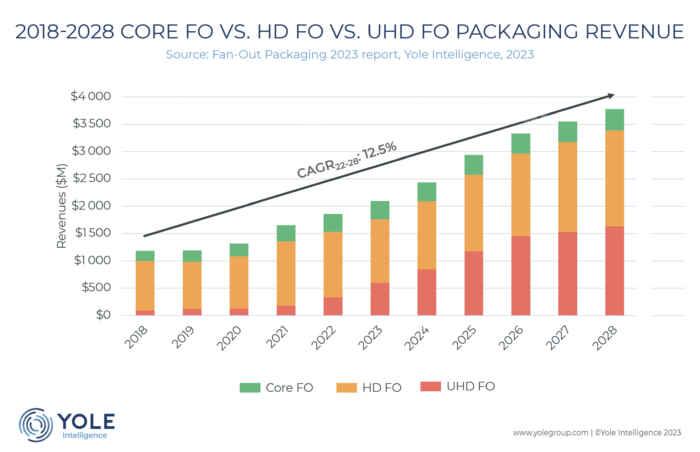
TSMC ialah pemain pembungkusan FO terbesar, dengan 76.7% daripada pasaran.
Chiplet dan integrasi heterogen memacu perkembangan pembungkusan FO.
Hasil pembungkusan FO ialah $1.86 bilion pada 2022. Yole menjangkakan ia akan mempunyai CAGR sebanyak 12.5% hingga 2028, mencecah $3.8 bilion.
FO UHD (Ultra-High Density) akan mengalami pertumbuhan terpantas merentas semua kelas pasaran, dengan CAGR sebanyak 30%, meningkat daripada $338 juta pada 2022 kepada $1,630 juta pada 2028.
“FO HD (Ketumpatan Tinggi) ialah kelas pasaran yang mendominasi pada 2022 dengan hasil $1,194 juta, dan ia akan mempunyai CAGR 6.7%, mencecah $1,757 juta pada 2028,” kata Gabriela Pereira dari Yole, “FO teras akan mempunyai CAGR 2.8% , meningkat daripada $329 juta pada 2022 kepada $389 juta pada 2028.”
Jumlah FO WLP (Pembungkusan Tahap Wafer) masih akan menguasai pasaran, dengan pengeluaran wafer sebanyak 2,376K pada 2028, berbanding pengeluaran bersamaan wafer 238K 300 mm untuk FO PLP .
Jumlah volum pakej FO akan meningkat daripada 2,348 juta unit pada 2022 kepada 2,960 pada 2028.
TSMC ialah pemain pembungkusan FO terbesar, dengan 76.7% daripada pasaran”.
Tiga syarikat OSAT teratas, ASE, Amkor dan JCET, bersama-sama dengan TSMC, mempunyai lebih daripada 90% pasaran peminat pada tahun 2022.
Pembungkusan FO telah berkembang daripada pembungkusan yang rendah teknologi menjadi platform penyepaduan berprestasi tinggi, dengan penggunaan yang semakin meningkat dalam pasaran mudah alih HPC, rangkaian, automotif dan kelas atas.
Salah satu trend pasaran utama yang memacu teknologi pembungkusan kipas adalah pembahagian cetakan besar kepada serpihan dan integrasi heterogen.
Fan-out ialah platform kos efektif yang membolehkan sambungan mati-ke-mati lebar jalur tinggi dan berketumpatan tinggi melalui proses berasaskan RDL.
UHD FO akan mengambil bahagian pasaran daripada Si Interposers pada masa hadapan melalui FO-on-substrat yang inovatif dan jambatan FO-embedded
TSMC ialah peneraju pasaran dalam penyelesaian FO berprestasi tinggi untuk aplikasi pengkomputeran, rangkaian dan HPC canggih.
ASE, SPIL, Samsung, JCET, Amkor, PTI, TFME dan Nepes sedang membangunkan penyelesaian serupa dengan potensi besar untuk bersaing.
Walaupun teras FO ialah pasaran OSAT utama, perkembangan utama adalah dalam teknologi HD dan FO UHD.
FO PlP (Pembungkusan Tahap Panel) telah digembar-gemburkan sebagai penyelesaian untuk penggunaan meluas FO, terutamanya untuk saiz pakej yang besar.
Walau bagaimanapun, ia masih memberikan cabaran teknikal, dan terdapat kekurangan permintaan untuk mencapai manfaat kos yang diingini