Novos OSATs chineses estão penetrando na cadeia de suprimentos de embalagens FO, como ECHINT (antigo ESWIN), Casmeit e Sky Semicondutores.
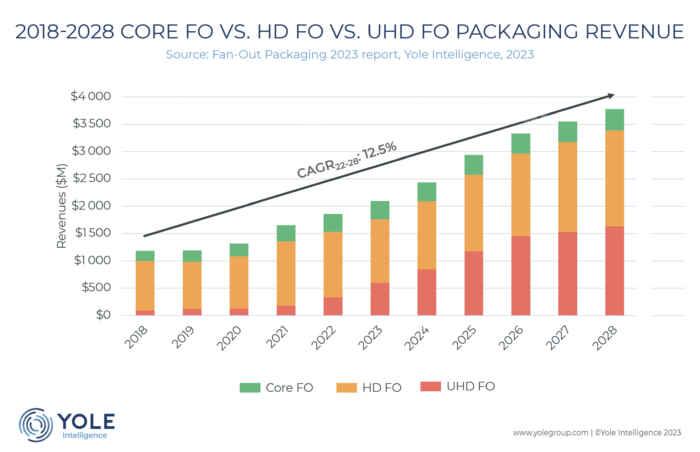
A TSMC é a maior operadora de embalagens FO, com 76.7% do mercado.
Chiplets e integração heterogênea estão impulsionando o desenvolvimento de embalagens FO.
A receita de embalagens FO foi de US$ 1.86 bilhão em 2022. Yole espera que tenha um CAGR de 12.5% até 2028, atingindo US$ 3.8 bilhões.
UHD (Ultra-High Density) FO experimentará o crescimento mais rápido em todas as classes de mercado, com um CAGR de 30%, passando de US$ 338 milhões em 2022 para US$ 1,630 milhões em 2028.
“HD (Alta Densidade) FO é a classe de mercado dominante em 2022, com US$ 1,194 milhões em receita, e terá um CAGR de 6.7%, atingindo US$ 1,757 milhões em 2028”, diz Gabriela Pereira da Yole, “o núcleo FO terá um CAGR de 2.8% , aumentando de US$ 329 milhões em 2022 para US$ 389 milhões em 2028.”
O volume de FO WLP (Wafer-Level Packaging) ainda dominará o mercado, com produção de wafer de 2,376K em 2028, contra produção equivalente de wafer de 238K de 300 mm para FO PLP.
O volume total de embalagens FO crescerá de 2,348 milhões de unidades em 2022 para 2,960 em 2028.
A TSMC é a maior operadora de embalagens FO, com 76.7% do mercado”.
As três principais empresas OSAT, ASE, Amkor e JCET, juntamente com a TSMC, detinham mais de 90% do mercado fan-out em 2022.
A embalagem FO evoluiu de uma embalagem de baixo custo tecnologia em uma plataforma de integração de alto desempenho, com adoção crescente nos mercados de HPC, redes, automotivo e móvel de alta tecnologia.
Uma das principais tendências de mercado que impulsionam a tecnologia de embalagem fan-out é o particionamento de matriz grande em chiplets e a integração heterogênea.
Fan-out é uma plataforma econômica que permite interconexões die-to-die de alta densidade e alta largura de banda por meio de processos baseados em RDL.
O UHD FO conquistará participação de mercado dos Si Interposers no futuro por meio da inovadora ponte FO-on-substrate e FO-embedded
A TSMC é líder de mercado em soluções FO de alto desempenho para aplicativos de computação, rede e HPC de ponta.
ASE, SPIL, Samsung, JCET, Amkor, PTI, TFME e Nepes estão desenvolvendo soluções semelhantes com enorme potencial para competir.
Embora FO central seja o principal mercado OSAT, os principais desenvolvimentos estão nas tecnologias HD e UHD FO.
A FO PlP (Panel-Level Packaging) tem sido considerada a solução para a ampla adoção de FO, especialmente para embalagens de grandes tamanhos.
No entanto, ainda apresenta desafios técnicos e falta de demanda para atingir o custo benefício desejado